愭抂僨僶僀僗尋媶晹
丂僔儕僐儞敿摫懱媄弍偺彨棃傪揥朷偟偮偮丄変乆偼僂僄僴乕僗働乕儖偱暯扲側僔儕僐儞昞柺忋偱榗傒傪恖岺揑偵惂屼偡傞庤朄傪採埬偟丄偦偺桳梡惈傪僫僲峔憿宍惉偵偍偄偰弶傔偰幚徹偟偨丅嵟嬤丄帺屓慻怐揑側僫僲峔憿宍惉偼岝儕僜僌儔僼傿朄偺僒僀僘尷奅偺惂栺傪庴偗側偄揰偱枺椡揑側媄弍偲偟偰拲栚傪廤傔偰偄傞丅偟偐偟丄僔儕僐儞婎斅忋偵帺屓慻怐壔偡傞僎儖儅僯僂儉偍傛傃僔儕僐儞僎儖儅僯僂儉偼僫僲僗働乕儖偺峔憿傪梕堈偵宍惉偱偒傞棙揰偼偁傞偑丄嬊強揑側埵抲惂屼偑崲擄偱偁傞偲偄偆杮幙揑側栤戣傪書偊偰偄傞丅寢壥偲偟偰丄帺屓慻怐壔傪僨僶僀僗嶌惢偺婎杮僾儘僙僗偲偟偰梡偄傞偺偼丄尰忬偺媄弍偺傑傑偱偼崲擄偱偁傞丅
丂偦偙偱変乆偼丄僫僲峔憿宍惉偺埵抲惂屼傪幚尰偡傞偨傔偵丄僔儕僐儞僂僄僴乕昞柺偺榗傒暘晍傪惂屼偡傞曽朄傪妋棫偟偨丅偡側傢偪丄僔儕僐儞僂僄僴乕忋偵惉挿偝偣偨僔儕僐儞巁壔枌偺惉挿憌傪岝儕僜僌儔僼傿朄偱擟堄偺僷僞乕儞偵壛岺偟偰偐傜丄僂僄僴乕昞柺偵巁慺僀僆儞拲擖偡傞丅偦偺屻丄偦偺帋椏傪1325亷偱傾僯乕儖偟丄壔妛僄僢僠儞僌偱巆偝傟偨惉挿憌傪偡傋偰彍嫀偡傞丅偙偺僾儘僙僗偵傛傝僷僞乕儞椞堟偺傒偵僔儕僐儞巁壔暔傪杽傔崬傓偙偲偑偱偒傞丅僔儕僐儞巁壔暔偺懱愊偼僔儕僐儞偺栺2攞偵憡摉偡傞偺偱丄杽傔崬傑傟偨僔儕僐儞巁壔暔偼僔儕僐儞婎斅撪晹偵榗傒応傪桿婲偟丄僔儕僐儞婎斅偺昞柺偱偼榗傒偺暘晍偑尰傟傞丅偙偺條偵偟偰宍惉偟偨杽傔崬傒僔儕僐儞巁壔暔偼彮側偔偲傕1325亷傑偱埨掕側偺偱丄偙偺榗傒暘晍傪傕偮昞柺忋偱偝傜偵嶌惢僾儘僙僗傪宲懕偡傞偙偲偑偱偒傞丅
丂幚嵺偵丄偙偺傛偆偵偟偰榗傒暘晍傪惂屼偟偨Si(001)婎斅忋偵挻崅恀嬻拞偱僎儖儅僯僂儉傪惉挿偝偣傞偙偲偵傛傝丄埵抲偲僒僀僘偑廫暘偵惂屼偝傟偨3師尦搰傪帺屓慻怐壔偡傞偙偲偑偱偒偨(恾侾)丅僎儖儅僯僂儉偼2師尦偸傟憌偺忋偵寚娮偺側偄3師尦搰傪宍惉偟側偑傜惉挿偟丄偙偺惉挿宍懺偼宯偺昞柺僄僱儖僊乕偲榗傒僄僱儖僊乕偺榓傪尭彮偝偣傞偙偲偵傛傝婲偙傞丅僎儖儅僯僂儉偺搰偼儔僀儞忬偺僀僆儞拲擖椞堟偱偼僒僀僘偑懙偄偟偐傕堦楍偵乮恾1(a)乯丄儂乕儖忬偺僀僆儞拲擖椞堟偱偼墌忬偵惉挿偡傞乮恾侾(b)乯丅
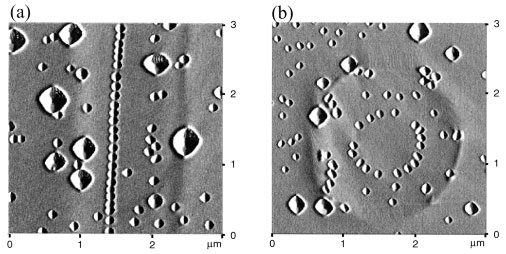
| 恾侾 | 700nm暆儔僀儞忬僀僆儞拲擖椞堟忋(a)丄偍傛傃2兪m宎儂乕儖忬僀僆儞拲擖椞堟忋(b)偵惉挿偟偨僎儖儅僯僂儉搰攝楍偺尨巕娫椡尠旝嬀憸 |