先端デバイス研究部
デバイスのサイズがナノメータのオーダとなり、デバイス中の主要部分が他の材料との界面近くにくる場合が多くなっている。したがって、これまでは無視しえた界面の影響をきちんと考慮しなければ、デバイス製作プロセスの設計、最適化ができなくなってきている。特に、ナノサイズへの微細化が最も進んでいるシリコン(Si)デバイスにおいては、シリコン酸化膜(SiO2)の膜厚が1ナノメータ(nm)と極薄となり、Si/SiO2界面からの影響がますます重大となっている。今回我々は、Si同位体を用いて、SiO2中の物質移動において最も重要なSi自己拡散に及ぼすSi/SiO2界面の影響について調べた。
質量数28Si(28Si)同位体の純度を99.9%まで高めたSi基板を熱酸化し、さまざまな膜厚をもつ28同位体Si酸化膜(28SiO2)を用意した。この試料に30Si原子をイオン注入した後、1150~1250℃でアニールを行い、30Si原子をマーカーにしてSi自己拡散を調べた。図1に示すように、SiO2膜厚が薄いほど、すなわち、Si/SiO2界面からの距離が小さいほど、Si自己拡散が大きいことを見出した[1]。この現象について、Si/SiO2界面でSi
+ SiO2 → 2SiOの反応によって生成したSiO分子が、SiO2中を拡散して30Siの存在する領域まで到達して30Si原子拡散(Si自己拡散)を促進するために、界面に近いほどSi自己拡散が促進されると考えた(図2)。このモデルを格子位置(s)にいる30Siと格子間位置(i)を拡散してきた28SiOが置き換わる反応式:
30Si(s) + 28SiO(i)  28Si(s) + 30SiO(i) で表し、拡散方程式を数値的に解くことで30Si原子の実験プロファイルを再現することができた(図1のシミュレーション)[2]。
28Si(s) + 30SiO(i) で表し、拡散方程式を数値的に解くことで30Si原子の実験プロファイルを再現することができた(図1のシミュレーション)[2]。
さらには、このシミュレーションから、SiO分子の拡散が遅いために界面からのSiO濃度が時間とともにゆっくりと増加し、Si自己拡散が時間とともに速くなると予測した。そして、実験によりこの時間依存性を確認することでモデルの正しさを実証した。この研究により、Si/SiO2界面が熱プロセス中において活性であり、界面付近の現象に影響を及ぼすことを明らかにした。例えば、1100℃、10秒のアニールでは、今回の結果から得られたSiOの拡散距離は0.4nmであり、SiO2膜厚が1nm以下では、界面の影響が無視できなくなると予測される。
[1] S. Fukatsu et al., Appl. Phys. Lett. 83 (2003) 3897.
[2] M. Uematsu et al., Appl. Phys. Lett. 84 (2004) 876.
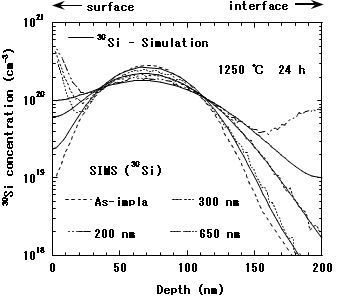 |
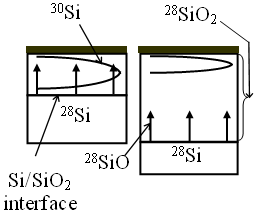 |
||||
|
|