c-BN薄膜のイオンビームアシストMBE成長におけるイオン照射効果
立方晶窒化ホウ素(c-BN)は大きなバンドギャップエネルギー(6.3 eV)を有するため、他の窒化物半導体とのヘテロ接合による高耐圧電子デバイスや紫外発光デバイスへの応用が期待される。BNではsp2結合の六方晶構造(h-BN)が安定相で、準安定相であるsp3結合のc-BNの成長は一般に困難であるが、我々は、ボロンの供給と同時に、加速したAr+とN2+を成長表面に照射することで、ダイヤモンド上にc-BN薄膜をMBE成長できることを報告してきた[1]。本研究では成長機構の解明やデバイス応用を行う上で重要な指針となるc-BNの成長相図を作成し、BNの結晶構造をAr+/ホウ素比(FAr+/FB)によって制御できることを明らかにした。
BN薄膜は、MBE装置を用いて、格子整合性の良いダイヤモンド(001)基板上(Δa/a=1.3%)に成長した。ホウ素はEB加熱により供給し、窒素源として窒素ラジカル(N*)を供給した。イオンの供給量がc-BN形成に及ぼす影響を明確にするため、成長中に照射するイオン種をAr+のみとした。V/III比(窒素/ホウ素比(FN*/FB))は>1とした。成長温度は920℃である。
図1は、Ar+照射を行わずに成長したBN薄膜と、Ar+照射(FAr+/FB>1)を行いながら成長したBN薄膜の赤外(IR)吸収スペクトルである。Ar+照射を行わない場合、sp2結合に由来する吸収ピークのみが観察され、熱力学的に安定なsp2結合のBN薄膜が成長する。一方、Ar+照射を行いながら成長した場合、sp3結合の吸収ピークのみが観察され、sp3結合のc-BN薄膜が成長する。図2は、このc-BN薄膜の断面TEM観察像と制限視野電子線回折(SAED)像であり、成長初期からc-BN(001)薄膜がエピタキシャル成長していることがわかる。
図3は、Ar+とホウ素の供給量を変化させてBN薄膜をc-BN(001)テンプレート上に再成長した際の成長相図である。c-BN薄膜がエピタキシャル成長した条件はすべてFAr+/FB>1であり、FAr+/FB<1の条件では、c-BNテンプレート上であっても乱れた層状構造をもつsp2結合の乱層BN(t-BN)が成長する。FN*は図3に示したすべての成長条件で一定としており、V/III比(FN*/FB)>1である。したがって、V/III比>1であればBN薄膜の成長相はV/III比には依存せず、FAr+/FBによって決まる。図3の成長相図とこれまでに明らかになっているc-BN薄膜の成長条件[1]から、c-BN薄膜のエピタキシャル成長には、V/III比>1かつ成長温度>750℃であることに加えて、FAr+/FB>1とする必要があることがわかった。
本研究は科研費の援助を受けて行われた。
- [1] K. Hirama et al., Appl. Phys. Lett. 104, 092113 (2014).

|
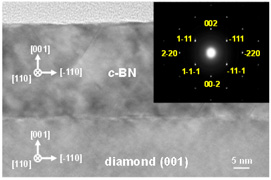
|
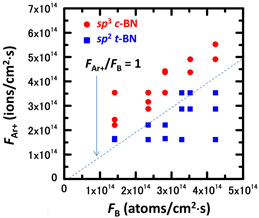
|
| 図1 BN薄膜のFT-IR吸収 スペクトル。 | 図2 c-BN(001)薄膜の断面TEM像とSAED像。 | 図3 イオンビームアシストMBE成長におけるBN薄膜の成長相図。 |