 恾侾丗係侽侽亷偵偍偗傞I-V摿惈
恾侾丗係侽侽亷偵偍偗傞I-V摿惈崅壏摦嶌 AlGaN/GaN 僿僥儘峔憿 FET
慜揷 廇旻丄惸摗 惓丄捴 岝懢榊丄惣揷 晀晇丄彫椦 捈庽
検巕暔惈尋媶晹
丂俧倎俶宯壔崌暔敿摫懱偼僶儞僪僊儍僢僾僄僱儖僊乕偑戝偒偔丄寢徎寢崌椡偑戝偒偄偨傔丄攋夡揹奅嫮搙偍傛傃朞榓揹巕懍搙偑崅偔丄崅壏丒崅懴埑丒崅弌椡摦嶌偺崅廃攇揹巕僨僶僀僗嵽椏偲偟偰旕忢偵桳朷偱偁傞丅変乆偼丄俙倢俧倎俶乛俧倎俶僿僥儘峔憿俥俤俿傪嶌惢偟丄係侽侽亷丂偺崅壏偵偍偄偰傕揹棳朞榓偍傛傃僺儞僠僆僼摿惈偺偲傕偵椙岲側僩儔儞僕僗僞摦嶌傪幚尰偟偨丅
丂嶌惢偟偨僿僥儘峔憿俥俤俿偼丄俁侽侽侌丂俙倢侽丏侾俆俧倎侽丏俉俆俶乛侾兪倣丂俧倎俶乛侾侽侽侽侌丂俧倎俶乛侾侽侽侽侌丂俙倢俶乛俽倝俠乮侽侽侽侾乯丂側傞憌峔憿傪帩偪丄僎乕僩挿偍傛傃僎乕僩暆偼偦傟偧傟丂俀偍傛傃俀侽兪倣偱偁傞丂乵岥奊嶲徠乶丅俙倢俧倎俶乛俧倎俶僿僥儘峔憿偵偍偄偰偼摿桳偺戝偒側埑揹岠壥偑懚嵼偟丄奿巕榗傒偺戝偒側奿巕旕娚榓峔憿傪梡偄傞偙偲偵傛傝丂侾亊侾侽侾俁丂們倣亅俀丂埲忋偺旕忢偵崅偄俀師尦揹巕擹搙偑幚尰偝傟傞乵侾乶丅恾侾偼係侽侽俷俠偵偍偗傞僩儔儞僕僗僞偺惷摿惈傪帵偟偨傕偺偱偁傞乵俀乶丅椙岲側揹棳朞榓摿惈偲摨帪偵丄椙岲側僺儞僠僆僼摿惈偑摼傜傟偰偄傞丅崅壏偵偍偄偰廬棃娤嶡偝傟偰偄偨僺儞僠僆僼摦嶌偺晄椙偼丄崅廃攇摿惈偺楎壔丄嶨壒偺憹戝丄慺巕懴埑偺掅壓摍丄戝偒側埆塭嬁傪媦傏偡偨傔丄僨僶僀僗偺幚梡壔偵偁偨偭偰偼椙岲側僺儞僠僆僼摦嶌偺幚尰偑晄壜寚偱偁傞丅恾侾偺椙岲側僺儞僠僆僼摿惈偼丄寢徎寚娮傗僄僢僠儞僌偵傛傞懝彎傪戝偒偔掅尭偟偨偙偲偵傛偭偰摼傜傟偨丅恾俀偼丄嶌惢偟偨俥俤俿偺憡屳僐儞僞僋僞儞僗乮倗倣乯偺壏搙乮俿乯埶懚惈傪帵偟偨傕偺偱偁傞丅壏搙忋徃偲偲傕偵倗倣偼掅壓偡傞傕偺偺丄俁侽侽俷俠埲忋偵偍偄偰偼倗倣偺掅壓棪偼彫偝偔丄嶌惢偟偨俥俤俿偺崅壏僨僶僀僗偲偟偰偺億僥儞僔儍儖偺崅偝偑帵偝傟偰偄傞丅僄儞僕儞丄梟峼楩側偳偺懠丄塹惎捠怣偱昁梫偲偝傟傞崅壏崅弌椡偺崅廃攇僨僶僀僗傊偺墳梡偑婜懸偝傟傞丅
[1] N. Maeda, T. Nishida, N. Kobayashi, and M. Tomizawa, Appl. Phys. Lett.
73(1998)1856.
[2] N. Maeda, T. Saitoh, K. Tsubaki, T. Nishida, and N. Kobayashi, to be
published in Jpn. J. Appl. Phys., Part 2 (1999).
 恾侾丗係侽侽亷偵偍偗傞I-V摿惈
恾侾丗係侽侽亷偵偍偗傞I-V摿惈
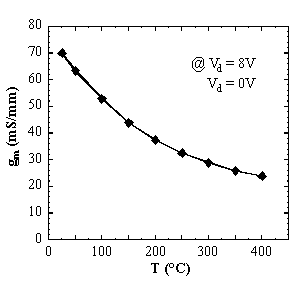 恾俀丗憡屳僐儞僟僋僞儞僗乮倗倣乯偺壏搙乮俿乯埶懚
恾俀丗憡屳僐儞僟僋僞儞僗乮倗倣乯偺壏搙乮俿乯埶懚