Å@
Toru Yamaguchi and Hiroshi Yamaguchi
Physical Science Laboratory
Å@Here, we report our novel method of aligning lamellar domains by means of graphoepitaxy using a resist pattern as an alignment guide [1]. Graphoepitaxy is a technique that uses the surface topography of the substrate to direct the epitaxial growth of the block copolymer film. The key to its success is the combination of the neutralization of a bottom surface and the introduction of a hydrophilic guiding pattern; this makes it possible to independently control the surface affinity of the substrate surface and the sidewall surface of the guiding pattern, which leads to the vertical orientation and lateral alignment of lamellar domains, respectively (Fig. 1). We have successfully demonstrated that the lateral alignment of the lamellar structure of a symmetric poly(styrene-b-methyl methacrylate) is achieved in confined spaces of about 3La (La: laterally aligned lamellar period, La Å` 32 nm) between hydrogen silsesquioxane (HSQ) resist patterns on a neutral surface (Fig. 2). It is important to consider that a lamellar structure with a period shorter than the pitch of the guide pattern could be formed by this method. We believe that the combination of the artificial layout of the guide patterns and the best polymer materials could lead to a new type of high-resolution lithographic technology in the 16-nm (1/2 La) regime.
[1] T. Yamaguchi and H. Yamaguchi, J. Photopolym. Sci. Technol. 19 (2006) 385.
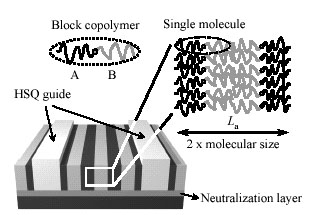 |
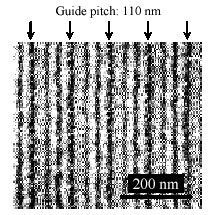 |
|||||
|
Å@Å@ |
|