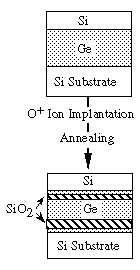
Si/Ge宯嵽椏偵偍偗傞巁壔偺慖戰惈傪棙梡偟偨怴偟偄峔憿宍惉朄傪採埬偡傞丅SiGe崿徎偺巁壔偵偮偄偰偼婛偵悢懡偔偺曬崘偑側偝傟偰偍傝丄Si偑桪愭揑偵巁壔偝傟傞偙偲偑椙偔抦傜傟偰偄傞丅偙偺斀墳傪Si/Ge懡憌枌偵揔梡偟丄奅柺偱Si偑桪愭揑偵巁壔偝傟傞偙偲傪梡偄偰丄敿摫懱/愨墢懱懡憌峔憿傪宍惉偡傞偙偲傪帋傒傞丅偦偺偨傔偵巁慺偺僀僆儞拲擖傪梡偄傞偑丄斀墳惈偺堎側傞嵽椏偐傜側傞懡憌枌拞偱偼丄拲擖偝傟偨僀僆儞偼丄廬棃偺僀僆儞拲擖偱偺尰徾偲偼旕忢偵堎側傞怳傞晳偄傪帵偡丅 丂
僾儘僙僗偺奣梫傪恾侾偵帵偡丅Si/Ge懡憌枌傪Si婎斅忋偵宍惉偟丄巁慺僀僆儞傪拲擖偡傞丅杮幚尡忦審偼丄Ge憌28nm丄Si忋憌30 nm偱偁傝丄拲擖僄僱儖僊乕丄30keV丄僪乕僗丄1x1017 c m-2偱偁傞丅拲擖屻丄悈慺媦傃Ar拞偱擬張棟傪峴偭偨丅恾俀偼丄僆乕僕僃揹巕暘岝(AES)偵傛傝挷傋偨Si丄Ge丄媦傃O偺怺偝曽岦慻惉暘晍偱偁傝丄(a)偼僀僆儞拲擖捈屻丄(b)偼400亷丄H2拞偱擬張棟偟偨屻丄偝傜偵600亷丄Ar拞偱30暘娫擬張棟偟偨屻偺暘晍偱偁傞丅巁慺偺暘晍偼丄僀僆儞拲擖偱捠忢傒傜傟傞僈僂僗暘晍偲偼挊偟偔堎側傝丄Si憌偲Ge憌偺奅柺偵廤拞偟偰偄傞丅拲擖帪偼婎斅壏搙傪100亷埲壓偵曐偭偰偄傞偺偱丄捠忢偺堄枴偱偺擬奼嶶偱嵞暘晍偟偨偺偱偼側偄丅擬張棟屻丄奅柺偱偺巁慺偺僺乕僋偑傛傝媫弒偵側傝丄傑偨丄Ge憌偺怺偄曽偺悶偵巁慺偺僺乕僋偲懳墳偡傞僨傿僢僾偑尰傟傞丅偡側傢偪丄僀僆儞拲擖捈屻丄奅柺晅嬤偼丂Si丄Ge丄媦傃廤拞偟偨O偺崿崌憌偱偁傞偑丄擬張棟夁掱偱SiO2偑宍惉偝傟傞偲摨帪偵丄Ge偺憒偒弌偟偑婲偒偰偄傞丅偙偺傛偆偵丄斀墳偺慖戰惈傪梡偄傞偲丄敿摫懱拞偵愨墢懱偲偟偰棟憐揑側摿惈傪帩偮SiO2傪懡憌偵杽傔崬傓偙偲偑偱偒丄戝偒側暵偠偙傔岠壥傪棙梡偟偨岝僨僶僀僗摍傊偺墳梡傕婜懸偝傟傞丅
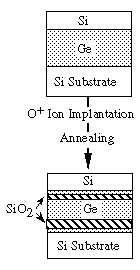
恾侾丗Si/Ge懡憌枌傊偺巁慺僀僆儞拲擖偵傛傞懡憌杽崬傒巁壔枌偺宍惉僾儘僙僗丅.
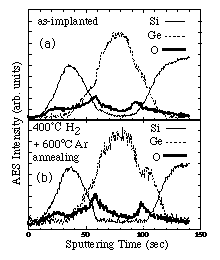
恾俀丗Si丄Ge丄O偺怺偝曽岦慻惉暘晍:
(a)拲擖捈屻偺暘晍丄(b)400亷偱H2拞擬張棟傪峴偭偨屻丄偝傜偵600亷偱Ar拞擬張棟傪峴偭偨偲偒偺暘晍
Go back to 1996 Annual Report Index.
Go back to Ogino Group Home Page.