量子物性研究部
SiやGaAsなどの従来の半導体に比べて、窒化物半導体は大きなバンドギャップを持っているため、高い電圧を印加しても壊れない。一方、ヘテロ接合バイポーラトランジスタ(HBT)の特徴は、大電流動作が可能な点である。これらのことから、窒化物半導体を使って作製したHBTは極めて高い出力を発揮することが期待できる。しかしながら、従来の窒化物半導体HBTには、電流利得が低く、コレクタ電流が流れ始める電圧(オフセット電圧)が高い、という二つの大きな問題点があった。このため、窒化物半導体HBTの高出力特性は理論的に予想されていたものの、実証されていなかった。
我々のグループでは、窒化物半導体HBTとして、GaN/InGaN HBTの研究開発を行ってきた。このGaN/InGaN HBTの特徴は、p型GaNに比べて抵抗の低いp型InGaNをベース層に用いており[1]、高い降伏電圧を得るためにダブルへテロ構造を採用している[2]、ことである。そして、外部ベース層にp型InGaNを選択成長する方法を開発することによって、従来よりも電流利得を100倍に、オフセット電圧を1/10以下にすることに成功し、窒化物半導体HBTにおける二つの問題点を解決した[3]。今回は、窒化物半導体HBTに期待される出力特性に関して研究を進めた。
HBTのベース・コレクタ接合は逆バイアスで使用され、ベース・コレクタ間ダイオードの逆方向降伏電圧が高いほど出力が高くなる。図1は、ベース・コレクタ間ダイオードの電流―電圧(I-V)特性を示している。バンドギャップの大きなGaNをコレクタに用いたために、-50Vでもリーク電流が少ないことが確認できた。一方、HBTの出力はエミッタ接地I-V特性におけるコレクタ電流にも依存する。図2はエミッタ面積とコレクタ電流の最大値の関係を示している。コレクタ電流はエミッタ面積に比例して増加することがわかる。逆方向降伏電圧はエミッタ面積に依存しないことから、図2はHBTの出力がエミッタ面積に比例して増加することを示している。現在のところ、エミッタ面積が90
μm x 50 μmのHBTに対して、エミッタ接地I-V特性における直流出力は10Wを超えている。そして、出力密度は1cm2当たり270,000
Wにも達し、窒化物半導体HBTの高出力特性を初めて実証することに成功した[4]。
[1] K. Kumakura et al., Jpn. J. Appl. Phys. 39 (2000) L337.
[2] T. Makimoto et al., Appl. Phys. Lett. 79 (2001) 380.
[3] T. Makimoto et al., Appl. Phys. Lett. 83 (2003) 1035.
[4] T. Makimoto et al., Appl. Phys. Lett. 84 (2004) 1964.
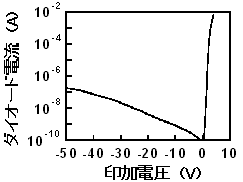 |
 |
||||
|
|