赤坂哲也 小林康之 嘉数誠
機能物質科学研究部
GaNをはじめとする窒化物半導体では、成長機構の解明、界面揺らぎのないヘテロ構造の作製、および、サブバンド素子への応用の見地から、原子レベルで平坦な表面やヘテロ界面の実現が望まれる。しかしながら、従来は螺旋・混合転位に起因するスパイラル成長のため、窒化物半導体の表面は高密度のモノレーヤステップで構成されていた。本研究では、低転位密度のGaN基板を用い、さらに、成長条件を最適化することにより、1分子層の段差もない単一のテラスで構成された完全平坦面(ステップフリー面)を有するGaN薄膜を得ることに成功した[1]。
転位密度が106 cm-2以下である単結晶GaN (0001) 基板の表面にSiO2マスクを形成した後、フォトリソグラフィにより1辺が8 µm(直径16 µm)の正六角形の開口部を開けた。これを基板としてGaN薄膜の有機金属気相エピタキシ (MOVPE) による選択成長 (SA-MOVPE) を行った。原料ガスは、アンモニアおよびトリメチルガリウム (TMG) である。
TMG流量26 µmol/min、基板温度940ºCで選択成長したGaN薄膜の表面のAFM像を図1に示す。周辺部に数層のモノレーヤステップが見られるが、GaN表面は単一のテラスでほぼ覆われている。一方、同一の成長条件で、(選択成長ではなく)通常成長したGaN表面は、ステップ間隔が0.1 µm程度の高密度のモノレーヤステップから構成されていた(図2)。さらに、選択成長した場合でも、成長条件がずれていると、GaN表面には数10本のモノレーヤステップが存在した。
このように、GaN基板の転位密度、成長領域制限(選択成長)、および、成長条件という3つの条件を整えることにより、GaNにおいても大きさ16
µm程度のステップフリー面を作製することが可能になった。
[1] T. Akasaka, Y. Kobayashi, and M. Kasu, Appl. Phys. Express 2 (2009) 091002.
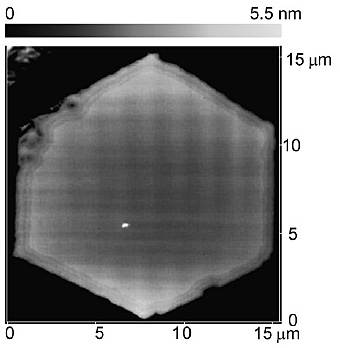 |
 |
|||||
|
|