尾身博雄 影島愽之*
機能物質科学研究部 *量子電子物性研究部
SiO2/Si (001) 界面はシリコンおよびシリコン関連のナノテクノロジおいて最も重要な界面の1つである。したがって、その重要性のゆえに酸化により引き起こされるシリコン表面および酸化膜界面でのラフネスのメカニズムを解明するために多くの研究がなされてきている[1, 2]。この研究では、アルゴン酸素ガス雰囲気中で高温熱酸化した酸化膜とシリコン基板との界面の形態を酸化温度、酸化時間、基板のミスカットを関数として、原子間力顕微鏡 (AFM) と放射光X線反射率測定 (XRR) により系統的に調べた[3]。熱酸化後エッチングにより熱酸化膜を除去したSi (100) 基板をAFM観察した結果から、熱酸化温度が1150ºC以下で界面ラフネスは顕著に変化しないこと[図1の領域(I):安定化領域]、1150-1250ºCでステップテラス構造が界面に形成することによりラフネス (RMS) が急激に増加すること[図1の領域(II):不安定化領域]、酸化温度が1250ºC以上では基板のミスカット (< 4º) に依存せず平坦化する[図1の領域(III):安定化領域]ことが分かった。この酸化温度に依存した反応界面の安定化−不安定化転移の現象は熱酸化膜の粘性温度に密接に関連している。すなわち、熱酸化膜全体の歪み量、界面領域の歪み量により界面のラフネスが変化することを示唆している。XRRによる非破壊測定の結果はこの温度に依存性した界面形態の不安定化−安定化転移が酸化膜内の歪みの緩和機構に依存していることを支持している。確かに、図2に見られるようにXRRで求めたラフネスは、AFMで得られた結果と同様に酸化温度1150ºCから1250ºCまで急激に増加し[図2の領域(II)]、1250ºCで最大となり、その後徐々に減少する[図2の領域(III)]。さらに、XRR測定では酸化膜の表面、酸化膜と中間層の界面のラフネスの酸化膜依存性を同時に求めることができ、その結果はシリコンとシリコン酸化膜の界面のラフネスが酸化膜内での歪み解放の機構に支配されていることを示している。
[1] Fundamental Aspects of Silicon Oxidation, edited by Y. J. Chabal (Springer, 2001).
[2] H. Omi, H. Kageshima, and M. Uematsu, Phys. Rev. Lett. 97 (2006) 01602.
[3] H. Omi, H. Kageshima, T. Kawamura, M. Uematsu, Y.Kobayashi, S. Fujikawa, Y. Tsusaka, Y. Kagoshima, and J. Matsui, Phys. Rev. B. 79 (2009) 245319.
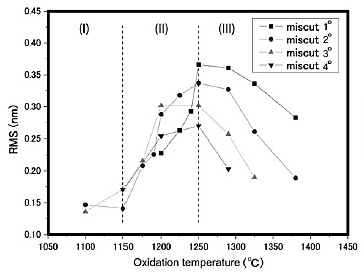 |
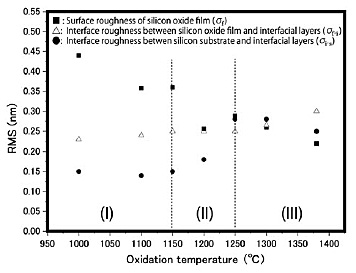 |
|||||
|
|