Si基板上にMOVPE成長したGaAs/Ge構造の熱サイクルアニールによる転位低減
Si基板上にIII-V族化合物半導体を直接成長により形成することは、30年に渡り研究され続けている。近年は、III-V族材料であるGaAsとSi基板の間にGaAsと格子定数が近いGeバッファ層を導入し、GaAs層の結晶性を向上させる研究が進められている[1]。Geバッファ層を作製する手法として、モノゲルマン(GeH4)を用いて気相成長するものが広く用いられているが、GeH4は分解爆発性の材料でありIII-V族材料の成長装置に適合しない問題があった[2]。我々はGeH4に変えて、有機金属材料であるイソブチルゲルマン(iso-butyl germane, IBGe)を使用し、GaAs成長と同じ有機金属気相成長(Metal-Organic Vapor Phase Epitaxy, MOVPE)装置にてGeバッファ層およびGaAs層の一括成長を行った。図1(a)にこの試料の断面透過電子顕微鏡(Transmission Electron Microscopy, TEM)像を示す。GaAs層とGeバッファの間には、界面にて発生したと考えられる転位が形成されており、これが成長層表面へ伸びている様子が観察された。この試料に対し、成長後に熱サイクルアニール(Thermal Cycle Annealing, TCA)を施すと、界面での転位が低減し、成長表面への転位の貫通が抑制されていることがわかる[3]。また、これらの試料上部にInGaAs/GaAsからなる多重量子井戸(Multiple Quantum Well, MQW)を成長し、このMQWからのフォトルミネッセンス(Photoluminescence, PL)を測定した(図2)。PL強度は、TCAを施すことによって3倍程度に増強されることが判明した。一方で、同様のMQWをGaAs基板上に作製したものに対して発光強度は11%程度であるため、さらなる結晶性の向上が求められる。これらの技術により結晶性がデバイス作製品質となれば、半導体レーザをはじめとする半導体光デバイスをSi基板上に直接集積することが可能となる。
- [1] A. Lee et al., Opt. Express 20, 22181 (2012).
- [2] M. E. Groenert et al., J. Appl. Phys. 93, 362 (2003).
- [3] R. Nakao et al., in Electronic Materials Symposium 34, Th-2-3 (2015).
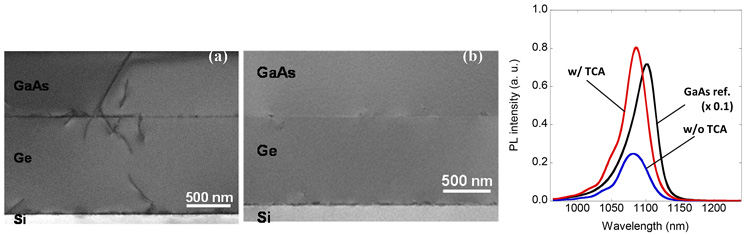
|
|
|
図1 断面TEM像。(a)成長後および(b)TCA後。 |
図2 MQWからのPLスペクトル。 |