熊倉一英 *廣木正伸 牧本俊樹
機能物質科学研究部、*フォトニクス研究所
サファイア基板上に有機金属気相成長法により成長したGaNの結晶性は、低温堆積AlNやGaNを用いることで改善される。これらの低温堆積バッファー層は不安定なため、結晶成長の昇温中に様々な形状の島を形成することが良く知られている。したがって、満足のいく結晶性や再現性よくGaNを成長することが困難であり、このことは、産業的に見ても非常に重要な問題である。
ECRプラズマスパッタリングでは、緻密、均一、そして、安定な酸化膜や窒化膜を大面積に室温で容易に堆積することが可能である。融点が2000℃を超えるAl2O3やAlNも、ECRプラズマスパッタリングにより容易に室温で堆積することができる。つまり、これらの材料を熱的に安定なバッファー層として使うことが可能となるので、低温堆積AlNやGaNバッファー層の代わりに、ECRプラズマスパッタリングしたAl2O3/組成傾斜AlON/AlN/Al2O3層をバッファー層としたサファイア基板上のGaN成長を提案した。
c面サファイア基板上に、ECRプラズマスパッタリングにより、上述のバッファー層を室温で形成し、成長用の基板とした。バッファー層の全膜厚は20nmである。1000℃において、この基板上に、GaNを直接成長した。図1(a)と(b)は、サファイア基板とGaN成長層の界面におけるエネルギー分散型X線分光法(EDS)スペクトルと断面透過電子顕微鏡(TEM)像である。図1(a)に見られるように、窒素に起因するピーク強度は、サファイア基板からGaN層へと徐々に増加しているのに対し、酸素に起因するピークが減少していることが分かる。この結果は、酸化物層から組成を徐々に変化させ窒化物層を容易に形成できることを示している。
図2のように、断面の明視野TEM像から、成長の初期段階で転位が曲がっていることが分かる。このことは、横方向成長が促進されていることを示しており、GaN中の転位を低減させる働きをしている。転位密度は、6
× 108cm-2である。成長したGaNのキャリア濃度と移動度は、それぞれ、2 × 1017cm-3と
540cm2/Vsである。この結果は、ECRプラズマスパッタリングにより作製したバッファー層を用いて成長したGaNの品質が、これまでの低温堆積バッファー層を用いて作製したGaN層と同等かそれよりも優れていることを示している。
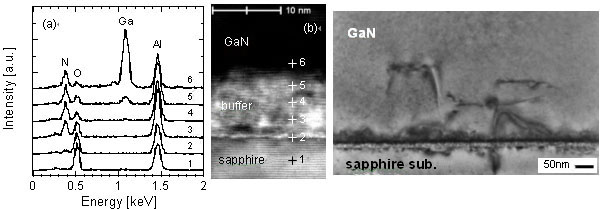 |
||||
図1 |
サファイア基板とGaN成長層の界面における(a) EDSスペクトルと、(b) 断面TEM像。 | 図2 | サファイア基板とGaN成長層の界面における断面TEM明視野像。 |
|