西川 敦 熊倉一英 牧本俊樹
機能物質科学研究部
窒化物半導体は大きなバンドギャップ、高い絶縁破壊電界を有することから、高温・高耐圧で動作する電子デバイスの材料として有望である。特に導電性基板を用いた縦型デバイス構造を作製することにより、さらなる低損失・大電流動作が可能となり、従来の半導体では実現できない低損失で動作するパワーデバイスの実現が期待される。
これまで、窒化物半導体を用いた縦型pnダイオードではp型GaN層が高抵抗であったり、ヘテロ基板上に窒化物半導体層を積層するためのバッファ層を挿入する必要があり、低抵抗デバイスの作製が困難であった。これに対して、我々はInGaN層をp型層として用いることでp型層の低抵抗化を実現した。また、近年、結晶性の改善が著しいGaN基板を用いることで、バッファ層が不要なp-InGaN/n-GaN縦型ダイオードを作製し、高耐圧、低オン抵抗を実現することに成功した[1]。
試料は有機金属気相成長法によりn型GaN基板上にp-InGaN(膜厚140 nm)/n-GaN(膜厚1.8
µm、3.6 µm)ダイオード構造を作製した。比較のためにn型SiC基板上にも同様のダイオード構造を作製した。図1に作製したpnダイオードの逆方向電流-電圧特性を示す。GaN基板上にGaN層を作製することにより結晶性の改善が見られ、リーク電流がSiC基板上に作製したダイオードと比較して1/10に低減できた。耐圧は主にn-GaN層の膜厚によって決定されるが、SiC基板上デバイス
ではGaN層を厚膜化すると結晶表面に亀裂(クラック)が生じ、デバイス性能が劣化する問題があった。一方、GaN基板上デバイスでは良好な結晶性を維持したまま3.6
µmのGaNが成長可能となり、571 Vという高い降伏電圧(VB)を得ることができた。高抵抗の要因となっていたバッファ層がGaN基板上デバイスでは不要であることから、図2に示すようにオン抵抗(Ron)は1.23 mΩcm2と低減できた。このように高耐圧、低オン抵抗を実現したことにより、デバイスの高出力性能を表す指数(VB2/Ron)は265 MW/cm2と窒化物半導体縦型デバイスとして最高値を実現した。
[1] A. Nishikawa, K. Kumakura, and T. Makimoto, Appl. Phys. Lett. 89
(2006) 153509.
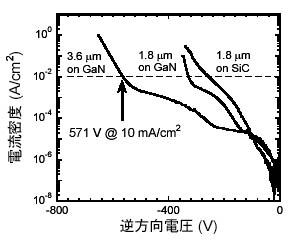 |
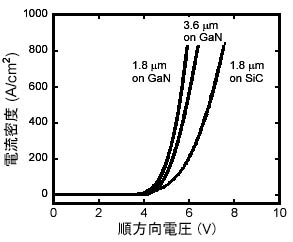 |
| 図1 逆方向電流-電圧特性 | 図2 順方向電流-電圧特性 |