小野行徳 西口克彦 藤原 聡
量子電子物性研究部
電界効果トランジスタは微細化の一途をたどり、これに伴い、トランジスタ中のドーパント数揺らぎに起因した特性ばらつきが大きな問題となっている。一方、シリコン中の少数個のドーパントを利用した新しい電子デバイスの可能性も検討されはじめている。このため、ドーパントがトランジスタ特性に及ぼす影響を深く理解するとともに[1-3]、単一のドーパントを検出し、その位置を特定し、さらには、電子状態を制御する技術の確立が重要となる。今回我々は、単一ドーパント制御技術確立の第一ステップとして、トランジスタ中の単一ボロンの検出に成功した[4]。
ゲート長とゲート幅がともに40nmで、チャネルにボロンをドープしたナノトランジスタ(ソース、ドレインもp型)をsilicon-on-insulator基板上に作製した。作製においては、ソース、ドレインからチャネルへのドーパント拡散を防ぐために、ソース、ドレインとチャネルの間に電気的に形成可能なリードを挿入した。これにより、極低濃度のチャネルドーパントの影響を調べることが可能となった。図1は、トランジスタ中の平均ボロン数が約1個(ドーピング濃度:2×1016cm-3)の場合のコンダクタンス特性例である。矢印で示されている特性変調は、ドーピングされていないトランジスタでは観測されず、単一のボロンアクセプタに起因するものである。実際、ゲート電圧とドレイン電圧の関数として微分コンダクタンスをプロットした結果(図2)から、この特性変調が単一正孔の捕獲放出に起因していることが証明される。
コンダクタンス変調の基板電圧(VBG)依存性は、ランダムドーピングに起因して測定するデバイスごとに異なっている(図1)。このことは、特性変調がドーパントの界面からの距離(深さ)に強く依存していることを示唆しており、本測定手法を発展させることにより、トランジスタ中の個々のドーパントの位置を特定する技術を確立できるものと期待される。
[1] Y. Ono, et al., Jpn. J. Appl. Phys. 44 (2005) 2588.
[2] Y. Ono, et al., Phys. Rev. B 74 (2006) 235317.
[3] J. F. Morizur, et al., Phys. Rev. Lett. 98 (2007) 166601.
[4] Y. Ono, et al., Appl. Phys. Lett. 90 (2007) 102106.
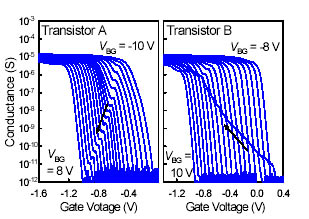 |
 |
|||||
|
|