山口 徹 山口浩司
量子電子物性研究部
ブロック共重合体リソグラフィ(BCL)は、トップダウン・ボトムアップ融合型のナノパターニング手法として注目されている。本手法は、ブロック共重合体のミクロ相分離したナノドメインをリソグラフィのテンプレートとして用いることを特徴としている。既存のトップダウンリソグラフィはまもなく22nm技術世代において限界を迎え、革新的なパターニング技術の開発が求められていることから、BCLの重要性は、近年非常に高まってきている。BCLの解像性は、ブロック共重合体の分子サイズのみにより決まるため、既存のリソグラフィの解像性を超える大きな可能性を秘めているからである。最も重要な課題は、種々のミクロ相分離ドメインの精密配向制御技術を確立することである。中でも、ミクロ相分離ドメインの一つであるラメラ構造は、そのライン形状、高いアスペクト比、パターン配置の自由度といったリソグラフィのテンプレートとしての多くの利点を有しており、ラメラ構造の配向制御を実現することが、将来の極微細ナノデバイス製作につながる非常に重要なステップとなる(図1)。しかしながら、ラメラ界面を2方向に、すなわち基板表面に垂直に、かつトップダウンリソグラフィにより形成したガイドに対して平行に、配向させなければならないという技術的な課題があった。
我々は、レジストパターンを配向ガイドとして用いたグラフォエピタキシ技術を新たに考案し、ラメラ構造の精密配向制御に成功した[1]。グラフォエピタキシとは、基板表面の凹凸を利用して、ブロック共重合体ミクロ相分離ドメインのエピタキシャル成長を促す手法である。成功の鍵は、基板表面の中性化と親水性配向ガイドパターンの導入にある。これにより、基板表面および配向ガイドの側壁表面の親和性を独立に制御することが可能となり、ラメラ構造の垂直配向および横方向配向を同時に実現することができた。図2に示すように、スチレンとメチルメタクリレートの対称ブロック共重合体を用いて、HSQレジストパターンからなる配向ガイド間に、3層のラメラドメイン(ラメラ周期La:約32nm)を横方向に配向させることに成功した。本手法により、配向ガイドのピッチよりも、狭い周期を持つラメラ構造を形成することが可能となった。本技術は、最先端のトップダウンリソグラフィ技術の解像性を大きく凌駕する16
nm (1/2 La)技術世代以降の極限リソグラフィ技術としての展開が期待される。
[1] T. Yamaguchi and H. Yamaguchi, J. Photopolym. Sci. Technol. 19 (2006) 385.
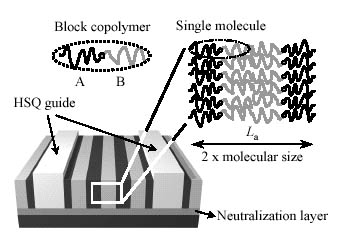 |
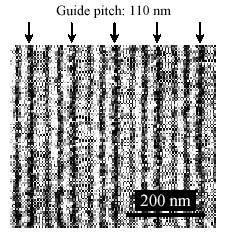 |
||||
|
|