西川 敦 熊倉一英 牧本俊樹
機能物質科学研究部
窒化物半導体を用いた電子デバイスはワイドギャップ材料の特性により、従来のGaAsやSiを用いたデバイスと比較して、高温・高耐圧における動作が期待される。我々はこれまでnpn型GaN/InGaNダブルへテロ接合バイポーラトランジスタ(DHBT)を作製し、室温において2000を超える高い電流利得と270
kW/cm2という窒化物半導体電子デバイスとして最大の電力密度動作を示してきた[1, 2]。今回、この素子の高温動作特性を調べるために、室温から300
℃までの電流‐電圧特性の温度依存性の測定を行った[3]。
測定した試料は有機金属気相成長法を用いて、SiC基板上にAlNバッファ層、n-GaNサブコレクタ層(1µm)、
n-GaNコレクタ層(500 nm)、組成傾斜InGaN層(30 nm)、 p-InGaNベース層(100
nm)、 n-GaNエミッタ層(40 nm)を積層した。p-InGaNベース層のIn組成は7%であり、エミッタ電極サイズは50×30
µm2とした。
図1にエミッタ接地電流-電圧特性を示す。ベース電流ステップは50 A/stepである。温度上昇により電流利得は減少するが、図1に示すように300
℃においても最大電流利得が308と高温においても高い値が得られることが分かった。最大電流密度は5.5
kA/cm2と高く、大電流動作が期待できる。図2に最大電流利得の温度依存性を示す。最大電流利得は温度上昇により、活性化エネルギーを0.13
eVとする指数関数的に減少することが分かった。温度上昇による電流利得の減少の要因がベース層からエミッタ層へのホールの逆方向注入電流であるとすると、活性化エネルギーが価電子帯バンドオフセットの値0.06
eVとなるが、今回得られた値はこの値よりも大きく、p型層のホールキャリアの活性化エネルギー(0.12
eV)とほぼ等しいことから、窒化物半導体HBTにおける電流利得減少はベース層のホール濃度が温度上昇により増加し、ベースにおける再結合電流が増加することが原因であることが示された。
[1] T. Makimoto, K. Kumakura, and N. Kobayashi, Appl. Phys. Lett. 83 (2003) 1035.
[2] T. Makimoto, Y. Yamauchi, and K. Kumakura, Appl. Phys. Lett. 83 (2004) 1964.
[3] A. Nishikawa, K. Kumakura, and T. Makimoto, Appl. Phys. Lett. 91 (2007) 133514.
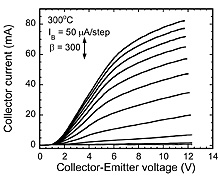 |
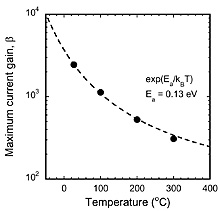 |
|
| 図1 エミッタ接地電流-電圧特性 | 図2 最大電流利得の温度依存性 |