植田研二 嘉数 誠
機能物質科学研究部
イオン注入法は幅広く用いられている半導体のドーピング法であるが、ダイヤモンドの場合
は、イオン注入時に生成する損傷が従来の熱アニール法では回復せず、ドーパントが活性化しない。これは、ダイヤモンドが大気圧下で準安定相であり、熱アニール時に安定相である
グラファイトに変化するからである。現在までに我々は、高温高圧 (HPHT) アニール法がイオン注入後のドーパントを活性化する手法として非常に有効であることを報告した[1]。今回我々は、HPHTアニールにより作製したホウ素(B)イオン注入層をチャネル層に用いたFETを作製したので報告する[2]。
Ib (100) 基板上に作製したホモエピタキシャルCVDダイヤモンド薄膜に、Bイオンを加速電圧60 keV、ドーズ量1015~1016 cm-2の条件で注入し、ダイヤモンド安定条件下の1350ºC、7 GPaの条件で、HPHTアニールを行った。次に、この薄膜を用いFETを作製した(図1)。ソース、ドレイン電極にはAu/Tiを用い、ショットキーゲート電極にはAlを用いた。また、RIEによりゲート下部をエッチングし、リセス構造とした。
ドーズ量の増加とともに、Bイオン注入薄膜のホール濃度は増加する傾向が見られ、Bドーズ量が3×1015 cm-2の薄膜で、室温シートホール濃度および移動度は1.6×1013 cm-2および 41 cm2/Vsとなった。これらは、我々がこれまで用いてきた水素終端法とほぼ同等の値である。この薄膜を用いて作製したFETのDC電流-電圧特性を図2に示す。典型的なショットキー型FET特性を示し、最大ドレイン電流値は0.15
mA/mmとなった。図中、矢印で示すように、ドレイン耐圧 (VBR) は530 V (EBR= ~1.1 MV/cm) となり、BドープCVDダイヤモンドショットキー ダイオードで得られている値に匹敵する値が得られた。これらの結果は、HPHTアニールにより得られるB注入層が高品質であることを示している。
この研究の一部は総務省SCOPE「ダイヤモンド高周波電力デバイス」プロジェクトの委託で行われた。
[1] K. Ueda, M. Kasu, and T. Makimoto, Appl. Phys. Lett. 90 (2007) 122102.
[2] K. Ueda and M. Kasu, Physica Status Solidi (c) 5 (2008) 3175.
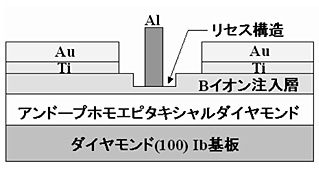 |
 |
|
| 図1 Bイオン注入ダイヤモンドFETの断面構造図。 | 図2 Bイオン注入ダイヤモンドFETの電流-電圧特性。 |