山崎謙治 山口浩司
量子電子物性研究部
3次元ナノ構造を作成する技術は、NEMS (ナノ電気機械システム)やナノロボティクスなど種々のナノテクノロジ応用を目的として、重要性が増してきている。我々が開発してきた3次元電子ビームリソグラフィ(3D-EBL)は、解像度・加工速度などの点で他の3次元ナノ加工技術より優れているが、電子散乱による近接効果が大きいこと、また3次元アライメント精度(位置精度)が十分でない、という問題があった。これらを解決する新しい手法を実現した。
3D-EBLによるレジスト材料加工の基本プロセスは、 (1) 基板上の厚膜レジスト塗布、 (2) 2次元EBLによるレジストブロック作製、 (3) 試料回転と様々な方向からのEB描画、等からなる。この手法で複雑な3次元ナノ構造を作製するためには、全く異なった方向からのEB描画をレジストブロック中で3次元的に位置合わせすること、つまり3次元アライメントを高精度に実現することが必要であった。そのために、透過電子像を用いた、高精度の試料回転制御 (<1 mrad) と回転させた試料上への2次元描画の十分な位置精度を得る手法を新たに開発した[1]。図1は、10 nmオーダの3次元アライメント精度を実証する、ネガレジスト(水素化シルセスキオキサン、HSQ)製の3次元ナノ構造である。ポジレジストを用いた場合、近接効果がより深刻になるが、目的となるレジスト構造の周囲に、散乱電子の一種である高速2次電子の飛程程度の寸法のバッファ領域(EBを照射しない領域)を設けるという、新たな手法を開発した。バッファ領域は、次の3D-EB描画のステップで除去する。この手法により近接効果を低減し、厚さ方向の構造の制御性を大幅に改善することができた[2]。図2は、ポジレジスト(ポリメチルメタクリレート、PMMA)製の3次元ナノ構造である。本手法により、高い構造自由度および高アスペクト比 (>10) を有する3次元ナノ構造が作製できることを実証した。
これらの手法により、3D-EBLの様々なナノテクノロジへの応用の加速が期待できる。
本研究の一部は科研費 (20246064) の援助を受けて行われた。
[1] K. Yamazaki and H. Yamaguchi, J. Vac. Sci. Technol. B 26 (2008) 2529.
[2] K. Yamazaki and H. Yamaguchi, Appl. Phys. Exp. 1 (2008) 098001.
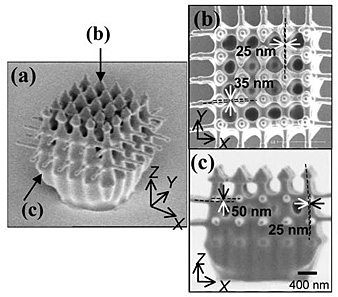 |
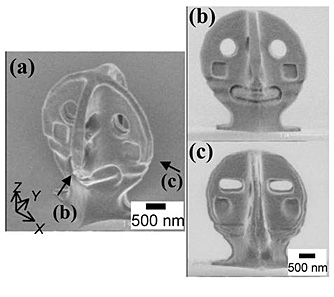 |
|||||
|
|