登坂仁一郎 西口克彦 小野行徳 影島博之 藤原聡
量子電子物性研究部
近年、Si中リン原子の電子状態は、固体量子コンピュータへの応用の観点から注目を集めている。本稿では、10 nm以下のSilicon On Insulator (SOI)チャネルを有するリンドープSOI-MOSFETにおける電流注入発光(EL)において、巨大なシュタルク効果を観測したので報告する[1]。
デバイスは、図1(a)に示すリンドープポリシリコンからなるトンネルゲートを有するSOI-MOSFETである。評価を行ったデバイスのSOIの膜厚(tSOI)は、8.5および25 nmとした。上面ゲート酸化膜厚(tFOX)および背面ゲート酸化膜厚(tBOX)は、それぞれ2および400 nmである。図1(b)にデバイスのポテンシャル図を示す。また、SOI層はデバイス作製時の熱処理により1017cm-3程度のリンドープが行われている。ELスペクトルは、温度80 Kにて評価を行った。電子は、上面ゲートより注入され、同時にp+コンタクトより正孔がSOI層に注入される。図2(a)は、tSOI = 25 nmのデバイスにおけるELスペクトルの背面ゲート電圧(VBG)依存性である。EL強度は、VBGが増加するに従い急速に減少している。これは、VBGを増加させるとSOI層に電界が加わり、電子はSOI/BOX界面に分布し、正孔と大きく分離するためと考えられる。一方tSOI = 8.5 nmのデバイスでは、ELスペクトルは複雑な振る舞いを見せている[図2(b)]。このデバイスでは、中性ドナーと自由正孔の再結合発光に伴うD0-hピークは、VBG = 136 V時に50 meVに及ぶ巨大なシュタルクシフトを示した。EL強度は、tSOI = 25 nmのデバイスがほぼゼロとなるVBGにおいても高い値を示し、その後VBG = 80 Vを超えた辺りから急速な減少を示した[図2(c)]。急速なEL強度の減少は、強い束縛状態からの電子解離により説明が可能である。SOI膜厚が薄いデバイスでは、SOIに形成される三角井戸ポテンシャル内の準位がリン束縛準位に対し高いエネルギーを取る。したがって、薄いデバイスでは、リンに束縛された電子は、容易には解離しないため、SOI膜厚が異なるデバイスで急速なEL強度減少を示す電界に差が現れたものと考えられる。
[1] J. Noborisaka et al., Appl. Phys. Lett. 98 (2011) 033503.
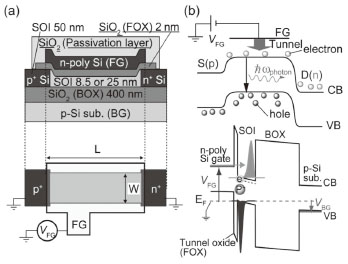 |
 |
|||||
|
|