選択成長MOVPEによる窒素極性GaN (000-1)の核成長および螺旋成長
原子層レベルで全く段差がない窒化物半導体ステップフリー面を用いれば、極めて急峻なヘテロ界面を有する量子素子が実現することが期待される。我々はこれまでに、MOVPE選択成長法を用いて、III族極性GaN(0001)ステップフリー面を実現した[1]。ここで、高温での成膜により適した窒素極性GaN(000–1)ステップフリー面が得られれば、それを土台としてInNやInxGa1–xNの高温成長が可能となり、従来困難であった窒化物半導体を用いた赤色や近赤外の高効率発光素子の実現に繋がると考えられる。ところが、窒素極性GaN(000–1)面成長の最適化はこれまで十分に検討されておらず、平坦な表面は得られていなかった。本研究では、窒素極性GaN(000–1)ステップフリー面の形成へ向け、MOVPE選択成長法を用いて、窒素極性GaN(000–1)面の成長機構を調べた。
GaN薄膜の成長は、MOVPE選択成長法を用いて窒素極性GaN(000–1)バルク基板上に行った。基板上には大きさ1 µmの六角形状開口部を多数設けたSiO2マスクを蒸着してある。原料ガスとしてアンモニアとトリメチルガリウム(TMG)を用いた。成長温度は1015℃である。
図1は、ほぼステップフリーとなった窒素極性GaN(000–1)面のAFM像である。分子層ステップが1-2本観察される以外は巨大な原子テラスによって表面がおおわれている。この六角形の領域では、らせん転位が全くないために核成長モードで結晶成長が進行した。一方、同じ試料において、らせん転位がある六角形状開口領域では、GaNが、螺旋成長モードで成長した。窒素極性GaN(000–1)面の核成長および螺旋成長速度のTMG流量依存性を図2に示す。核成長速度はTMG流量を大きくしても極めて遅い。その一方で、らせん成長速度は急激に増加する[2] 。核成長速度が遅いことは、表面過飽和度が小さくて核生成頻度が低いことを意味している。この低い核生成頻度がステップフリー面に近い極めて平坦な窒素極性GaN(000–1)面を得るために重要であると考えられる。
本研究は科研費の援助を受けて行われた。
- [1]
- T. Akasaka, Y. Kobayashi, and M. Kasu, Appl. Phys. Express 2 (2009) 091002.
- [2]
- C.H. Lin, T. Akasaka, and H. Yamamoto, Appl. Phys. Express 6 (2013) 035503.
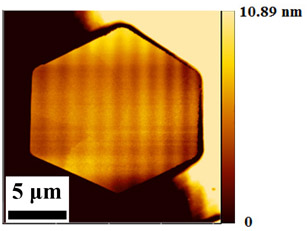 |
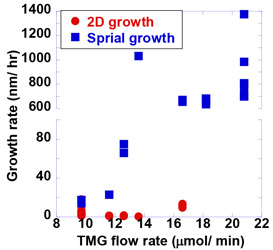 |
|
|