III族原料流量変調エピタキシにより成長したヒルロックフリー窒素極性GaN(0001)薄膜
窒化物半導体の窒素極性(0001)面では、結晶表面からの窒素原子の再脱離が起きにくい。そのため、特に窒素脱離が問題であるInNやInGaNの結晶性向上が期待できる。ところが、窒素極性(0001)面成長では、表面にヒルロックが多数形成されて平坦性が悪いのが大きな問題となっている。本報告では、III族原料の流量を周期的に変調するIII族原料流量変調エピタキシ(III族原料FME)を用いて、ヒルロックフリーGaN(0001)薄膜が成長できることを報告する[1]。
III族原料FMEでは、原料ガスのNH3は連続的に供給する一方、III族原料のトリメチルガリウム、または、トリエチルガリウムの流量を変調する。すなわち、大流量のIII族原料(21 µmol/min)を1秒間、および、小流量のIII族原料(10 µmol/min)をt秒間(t: 0~10)、交互に供給した。小流量のIII族原料供給中には、Gaの成長表面への吸着と再脱離がバランスしており、GaNの成長もエッチングも起こらず、Gaの表面拡散のみが促進される[1]。この交互供給を900サイクル繰り返し、約450 nmの厚さのGaN(0001)薄膜を成長した。
GaN(0001)薄膜の光学顕微鏡写真を図1に示す。連続成長の場合、数個のヒルロックがあるが
[図1(a)]、III族原料FMEではヒルロックが全く見られず[図1(b)]、10 mm×5 mmのサンプル全体にわたってもヒルロックフリーであった。ヒルロック密度の小流量供給時間tに対する依存性を図2に示す。t=1sでもヒルロックは大幅に減少しており、t≧5sでほぼヒルロックフリーとなった。ここで、断面透過型電子顕微鏡の観察等からヒルロックの中心にはらせん転位が存在することが分かった。すなわち、通常の連続的な成長では、ヒルロックはらせん転位を起源とする渦巻き状の螺旋成長により大きく発達していく。一方、III族原料FMEでは、小流量のIII族原料を供給する間にGaの表面拡散が促進されるので、ヒルロックを発達させる螺旋成長よりも平坦な表面を形成するステップフロー成長が支配的になる結果、ヒルロック形成が抑制されるものと考えられる。
- [1] C. H. Lin, T. Akasaka, and H. Yamamoto, Jpn. J. Appl. Phys. 55, 04EJ01 (2016).
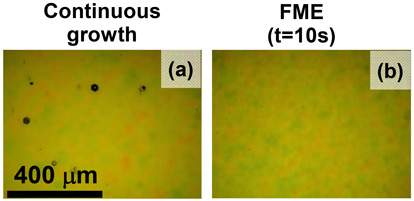
|
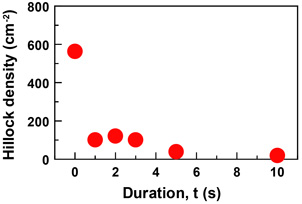
|
| 図1 窒素極性GaN(0001)薄膜表面の光学顕微鏡写真。 (a)連続成長および(b)III族原料FME (t =10s)。 | 図2 ヒルロック密度の小流量供給時間tに対する依存性。 |