ゲート制御によるInAs/GaSbヘテロ構造の半金属-トポロジカル絶縁体転移
トポロジカル絶縁体(TI)は従来の物質の分類に当てはめることのできない新しい物質の形態である。その内部は絶縁であるが、外界の絶縁状態とはトポロジーが異なり、必然的にTI内部と外界の境界に伝導チャネルが現れる。この伝導チャネルは散乱の抑制された特異な伝導を示すことが予測され、新しい物性の発現が期待されている。特に、二次元TIは無散逸な伝導が予測されることから、省電力デバイスとしても期待されている。
これまで我々は、一般的な半導体であるInAsとGaSbを用いてそのヘテロ接合により人工的に二次元TIを実現している[1]。今回我々は、このInAs/GaSbヘテロ接合構造の基板側と表面側両方にゲート電極を付け、外的な電圧制御による半金属-TIの転移を実現した[2]。これまで知られていたTIの性質に新たな機能性が加わりTIの応用が促進される。
図1はInAs/GaSbヘテロ接合構造のエネルギーバンドプロファイルで、InAsの伝導帯とGaSbの価電子帯が界面をトンネリングすることで混成し、外界とはトポロジーの異なるエネルギーギャップを形成する。伝導帯と価電子帯のエネルギー的な重複は基板側と表面側のゲート電圧で制御される。基板側のゲート電圧を高くするとポテンシャルの傾きが増し、エネルギー重複が小さくなる方向に働く。エネルギー重複が大きい場合はGaSbの価電子帯の異方性が強く現れ図2(a)のエネルギー分散関係で示したように半金属となり、エネルギー重複が小さい場合は図2(b)で示したようにTIとなる。
本研究は科研費(No. 26287068)の援助を受けて行われた。
- [1] K. Suzuki, Y. Harada, K. Onomitsu, and K. Muraki, Phys. Rev. B 87, 235311 (2013).
- [2] K. Suzuki, Y. Harada, K. Onomitsu, and K. Muraki, Phys. Rev. B 91, 245309 (2015).
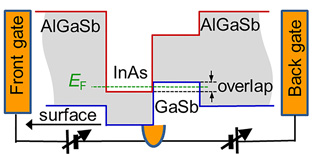
|
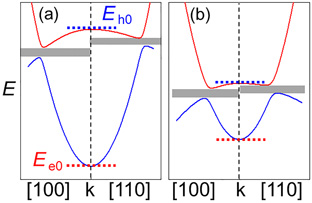
|
| 図1 InAs/GaSbヘテロ接合構造のエネルギーバンドプロファイル。 | 図2 エネルギー分散関係。(a)伝導帯と価電子帯のエネルギー重複が大きい場合は半金属、(b)小さい場合はトポロジカル絶縁体となる。 |