基板転写技術によるAlGaN/GaN高電子移動度トランジスタの放熱性の向上
窒化物半導体材料は、その高い絶縁破壊電界から高出力デバイスとしての応用が期待されている。しかし、大電流動作時には発熱によって出力が低下する、いわゆる自己発熱効果が生じる。そのため、高い動作出力を得るためには放熱特性を向上させる必要がある。我々は、六方晶窒化ホウ素(h-BN)を用いた窒化物半導体薄膜のエピタキシャルリフトオフ技術[1]を用いて、AlGaN/GaN高電子移動度トランジスタ(HEMT)を高放熱性基板に転写することでデバイスの温度上昇を抑制した[2]。今回、Au-Au熱圧着により転写することで、AlGaN/GaN HEMTの動作電流の大幅な増加と放熱性の向上を確認した[3]。
図1に、基板から剥離前および銅板へ転写後のAlGaN/GaN HEMTのI-V特性を示す。剥離前のデバイスでは、顕著な負性抵抗、すなわちドレイン電圧の増加に伴うドレイン電流の減少がみられる。一方、転写後のHEMTにおいては、このような電流減少が抑えられている。さらに、転写後において最大ドレイン電流が0.72 から0.91 A/mmへと大幅に増加し、最大相互コンダクタンスも110から140 mS/mm
へと増加した。これは、転写後において2次元電子ガス濃度が増加したことを示している。ラマン分光測定において、転写前後でGaNのE2のピークが約–1.3 cm–1シフトすることがわかった。サファイア基板からの剥離により内部圧縮応力が減少することを示している。この応力減少で2次元電子ガス濃度が上昇したと考えられる。
図2に、顕微ラマン分光によるデバイス動作中のHEMTのチャネル中の温度分布を示す。転写後のHEMTでは出力を0.3から1.5 Wに増加した場合、チャネル温度は50から150℃へと上昇した。一方、転写前においては、出力0.7 Wで240℃まで温度が上昇した。これらの結果は、h-BNを用いたエピタキシャルリフトオフ・転写技術が、窒化物半導体デバイスの放熱性改善および出力特性の向上に有効であることを示している。
- [1] Y. Kobayashi et al., Nature 483, 223 (2012).
- [2] M. Hiroki et al., Appl. Phys. Lett. 105, 193509 (2014).
- [3] M. Hiroki et al., Jpn. J. Appl. Phys. 55, 05FH07 (2016).
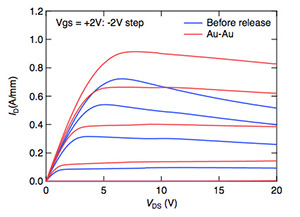
|

|
| 図1 剥離前および転写後の AlGaN/GaN HEMTのI-V特性 |
図2 AlGaN/GaN HEMTのデバイス動作時の温度分布 |